2. 苏州瑞红电子化学品有限公司, 江苏 苏州 215124
2. Suzhou Ruihong Electronic Chemicals Co. Ltd., Suzhou 215124, Jiangsu, P.R.China
光致抗蚀剂,又称光刻胶,是一类对光或射线敏感的混合聚合物材料,其溶解性、熔融性、附着力等在曝光前后会发生显著变化。依据曝光区域的光致抗蚀剂在显影过程中的去除或保留,可将其分为正性光致抗蚀剂和负性光致抗蚀剂两大类。光致抗蚀剂被广泛的应用于印刷电路板(PCB)、彩色滤光片、纳米器件制造等[1,2,3,4,5,6] 微电子领域,其主要由成膜树脂、活性稀释剂、光引发剂、溶剂、颜料、助剂等组成。其中,成膜树脂是其他组分的载体,能溶于显影液,直接决定光致抗蚀剂的分辨率、耐热性及机械性能等。
在众多光致抗蚀剂的成膜树脂中,甲基丙烯酸酯类共聚物由于具有高透明度、合成工艺简单等优点,得到了广泛应用。然而,聚合物主链的线性结构导致其耐热性、耐蚀刻性不足。采用无机改性[7,8,9]的方法,虽然可以提高光致抗蚀剂的耐热性、耐蚀刻性及机械性能,但会带来无机-有机相之间相容性问题。因此,研究者[10,11,12]开始在聚合物侧链上引入苯环或脂肪环来提高光致抗蚀剂的耐热性及耐蚀刻性和机械性能等。N-苯基马来酰亚胺(N-PMI)单体含有平面五元环结构和刚性苯环结构,与甲基丙烯酸酯类单体共聚,可以提高共聚物的耐热性,用于光致抗蚀剂中,可以提高光致抗蚀剂的耐蚀刻性。含N-PMI共聚物在正性光致抗蚀剂中的应用已有报道 [13, 14, 15],而其在负性光致抗蚀剂中的应用却很少见。
本文以甲基丙烯酸(MAA)、甲基丙烯酸甲酯(MMA)、N-苯基马来酰亚胺(N-PMI)、甲基丙烯酸环己基酯(CHMA)为反应单体合成了一系列不同N-PMI含量的共聚物PMMNC,然后与甲基丙烯酸缩水甘油酯(GMA)反应,将碳碳双键引入到共聚物PMMNC中,得到甲基丙烯酸酯共聚物G-PMMNC,以G-PMMNC为基体树脂制备了负性光致抗蚀剂,研究了其相关性能。 1 实验部分 1.1 实验试剂
N-苯基马来酰亚胺(N-PMI),十二碳硫醇(1-DT):试剂级,上海阿达玛斯有限公司;甲基丙烯酸(MAA)、甲基丙烯酸甲酯(MMA)、三苯基膦(TPP)、对羟基苯甲醚(MEHQ):化学纯;醋酸丁酯(Butyl acetate)、丙酮(Acetone)、正己烷(Hexane)、偶氮二异丁腈(AIBN):分析纯,国药集团化学试剂公司;甲基丙烯酸缩水甘油酯(GMA):分析纯,上海晶纯实业有限公司;丙二醇甲醚醋酸酯 (PGMEA):工业级,无锡梅虹化工有限公司;甲基丙烯酸环己基脂(CHMA):GC,梯希爱(上海)化成工业发展有限公司;乙氧基化三羟基甲基丙烷三丙烯酸酯(TMP3EOTA):工业级,台湾长兴化学工业股份有限公司;2-甲基-1-(4-甲硫基苯基)-2-吗啉基-1-丙酮(Irgacure 907)、异丙基硫杂蒽酮(ITX):工业级,Ciba精化有限公司;酞青蓝:无锡广信油墨有限公司。 1.2 样品的性能及表征
红外光谱:将聚合物用丙酮溶解,涂在KBr盐片上,用加拿大ABBBOMEN公司的FTLA 2000-104型红外光谱仪测试,扫描波长500~4000 cm-1。核磁共振氢谱(1HNMR):瑞士BRUKER公司AVANCEⅢ型400 MHz核磁共振(1HNMR),用氘代二甲基亚砜(DMSO-d6)作溶剂。GPC测试:美国AGILLENT公司的1100型凝胶色谱仪,流动相为色谱纯THF,标样为聚苯乙烯(PSt)。玻璃化转变温度测定:Q200型差示扫描量热仪,美国TA仪器有限公司,升温速率20 ℃/min,温度扫描范围30~200 ℃。酸值测试:瑞士METTLER TOLEDO公司的T70型全自动电位滴定仪,滴定液选用氢氧化钾乙醇溶液。耐酸蚀刻性测试:将显影后的样品板置于10%HCl (体积百分比)溶液中于60 ℃条件下浸泡30 min,清水冲洗干净,晾干后观察线路图形的变化。分辨率测定:用日本日立公司的S-4800型扫描电子显微镜观测光致抗蚀剂的分辨率。美国F300S型无电极紫外灯系统曝光,输出功率120 W/cm2。涂膜:KW-4A型台式匀胶机以800转/分的速度旋涂20 s;QNix1500型测厚仪测量膜厚。 1.3 甲基丙烯酸酯共聚物G-PMMNC的合成
在装有搅拌器、滴液漏斗和温度计的三口烧瓶中,加入一定量的溶剂丙二醇甲醚醋酸酯(PGMEA)升温至90 ℃,将定量的单体甲基丙烯酸(MAA)、甲基丙烯酸甲酯 (MMA)、N-苯基马来酰亚胺(N-PMI)、甲基丙烯酸环己酯(CHMA)、引发剂偶氮二异丁腈(AIBN)、链转移剂正十二碳硫醇(1-Dt)和PGMEA混合均匀后匀速滴加到三口烧瓶中,1 h滴加完毕,继续保温反应6 h,得到甲基丙烯酸酯共聚物P(MAA-co-MMA-co-N-PMI-co-CHMA),简称PMMNC(制备示意图见图1)。升温至110 ℃,将阻聚剂对羟基苯甲醚(1%)、催化剂三苯基膦(2%)和甲基丙烯酸缩水甘油酯(GMA)的混合溶液匀速滴加到PMMNC中,并用PGMEA调节体系固含量至40%。测定体系酸值,直到酸值降至理论值时终止反应,得到甲基丙烯酸酯共聚物G-PMMNC。将G-PMMNC用正己烷提纯,得到纯化的聚合物粉末,用于性能测试。各组分配比见表1。
 | 图1 甲基丙烯酸酯共聚物G-PMMNC的制备示意图 Preparation of the methacrylate copolymer (G-PMMNC) |
| 表1 G-PMMNC 合成各组分配比 Composition of the G-PMMNC |
将甲基丙烯酸酯共聚物G-PMMNC (66.8%)、光引发剂/光敏剂(907/ITX=2,4.5%)、活性稀释剂(TMP3EOTA,11.5%)、染料(酞青蓝,3.9%)、醋酸丁酯(溶剂,13.3%)混合均匀,得到负性光致抗蚀剂,避光保存。 2 结果与讨论 2.1 红外分析
图2是共聚物PMMNC和G-PMMNC的红外谱图。从图中可以看出:曲线a中3500 cm-1处为羧基伸缩振动峰,3000 cm-1~3500 cm-1 处为苯环上不饱和C—H的伸缩振动峰,1745 cm-1处为酯基上CO的伸缩振动峰,1600 cm-1处为苯环骨架伸缩振动峰,1236 cm-1 和1100 cm-1 处为C—O伸缩振动峰,以上吸收峰说明各单体已经成功共聚形成PMMNC。比较a、b两条曲线可知:b在1635 cm-1处有CC双键伸缩振动吸收峰,说明GMA成功接枝到聚合物PMMNC上。
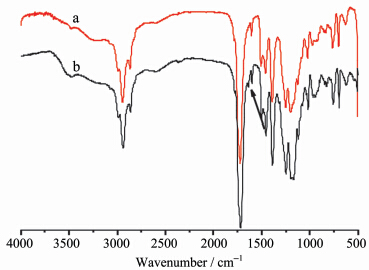 |
图2 共聚物的红外谱图
FT-IR spectra of copolymer (a) PMMNC,(b) G-PMMNC |
图3是共聚物PMMNC和G-PMMNC的1HNMR谱图,以氘代二甲基亚砜(DMSO-d6,δ=2.5)为溶剂。图中δ=0.9为主链上—CH3上的H,δ=1.7和δ=1.9为主链中—CH2—上的H,δ=2.7为主链中—CH—上的H,δ=3.6与δ=4.2附近为与氧原子相连的—CH3及—CH2上的H,δ=5.5和δ=6.1为双键上的H,δ=7.1与δ=7.6为苯环上的H,δ=12.5处为羧基上的H,环己基上5个亚甲基上的H在δ=1.4~1.8之间。核磁共振谱与红外光谱图分析结果表明已成功制得甲基丙烯酸酯共聚物G-PMMNC。
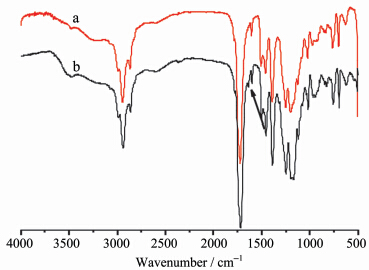 |
图3 共聚物的核磁谱图
1HNMR spectra of copolymer (a) PMMNC,(b) G-PMMNC |
共聚物的分子量对光致抗蚀剂的显影有重要影响,分子量过大,树脂碱溶性弱,显影时间过长甚至无法显影;分子量过小,则会造成显影过度,导致线路图形边缘出现腐蚀缺损等问题。图4是共聚物P1~P3的GPC曲线,表2是共聚物P1~P3的分子量及其分子量分布,共聚物P1~P3的数均分子量Mn由5545 g/mol增加至6536 g/mol,重均分子量Mw由8685 g/mol增加至13773 g/mol之间,分子量分布在1.56~3.95之间。聚合物P1~P3的分子量逐渐增大是因为N-PMI含量的增加导致聚合速率增大所致[16]。
 | 图4 共聚物P1~P3的GPC曲线 GPC curves of copolymer P1-P3 |
| 表2 聚合物P1~P3的分子量及其分子量分布 Molecular weight and molecular weight distribution of P1-P3 |
图5是DSC测得的共聚物G-PMMNC的Tg曲线,共聚物P1至P3的玻璃化转变温度(Tg)分 别为130.1 ℃、146.2 ℃、170.3 ℃。由实验结果可知:随着N-PMI含量的增加,聚合物的玻璃化转变温度(Tg)升高。聚合物的Tg与分子链的柔顺性相关,聚合物中N-PMI含量增大,五元环结构的空间位阻增大,而且N-PMI中的氮原子与苯环、羰基发生p-π共轭,进一步增加了分子链的刚性[15],使得分子链的柔顺性降低,聚合物玻璃化转变温度升高,因此三组聚合物的Tg表现出P3>P2>P1。
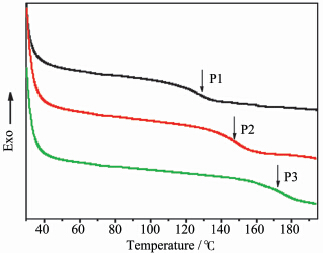 | 图5 共聚物P1~P3的DSC曲线 DSC curves of copolymer P1-P3 |
光致抗蚀剂的耐酸蚀刻性是其应用中的一个重要指标,主要取决于光致抗蚀剂光交联部分对酸性蚀刻液的耐蚀刻性。图6是共聚物P1~P3制备的光致抗蚀剂图案酸洗前后对比图,三组光致抗蚀剂图案酸洗后,线条清晰,没有发生腐蚀脱落的现象,只有P1对应光致抗蚀剂酸洗后颜色发生变化。N-PMI结构单元中存在强极性的羰基,可以增强分子间作用力;N-PMI中的平面五元环结构及苯环结构可以提高光致抗蚀剂的耐酸蚀刻性,因此,N-PMI含量降低,光致抗蚀剂的耐酸性下降。
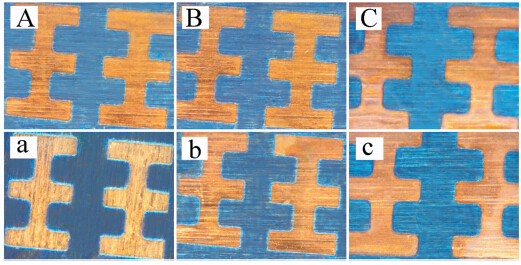 |
图6 聚合物P1~P3制备光致抗蚀剂酸洗前后对比图 A、B、C为酸洗前的图像,a、b、c为酸洗后的图像 Images of the photoresist prepared by copolymer P1-P3 before and after pickling A、B、C are images before pickling,a、b、c are images after pickling |
分辨率是衡量光致抗蚀剂的一个重要指标,分辨率越高,形成的关键尺寸越小。图7是共聚物P3制备的光致抗蚀剂在75 ℃下预烘30 min,无电极紫外灯系统曝光(127 mJ/cm2),1%Na2CO3中显影40 s得到SEM图,由图可以看出,制得的负性光致抗蚀剂图像轮廓清晰,以显影图形中的最小线宽计算,分辨率在40 μm左右。
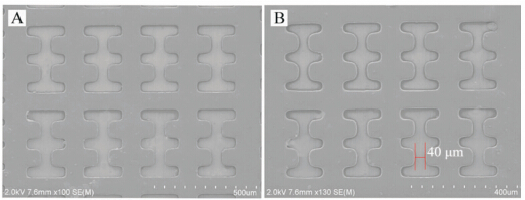 | 图7 共聚物P3制得负性光致抗蚀剂的SEM图像 SEM Images of the negative-type photoresist prepared by copolymer P3 |
表3是共聚物的酸值及光致抗蚀剂的膜厚。由表中数据可以看出:共聚物P1~P3酸值在94~97之间;P3制备的光致抗蚀剂的膜厚偏大,是共聚物P3分子量大,制备的光致抗蚀剂粘度大导致的,光致抗蚀剂的膜厚变化主要由共聚物中的羧基与显影液中Na2CO3反应造成,三组光致抗蚀剂的留膜率在84%~88%之间。
| 表3 共聚物的酸值及光致抗蚀剂的膜厚 The acid value and of copolymers and film thickness of photoresists |
通过两步法制备了一系列不同N-PMI含量的甲基丙烯酸酯共聚物G-PMMNC,利用FT-IR、1HNMR、GPC、DSC等表征了聚合物的结构与性能;以G-PMMNC为基体树脂制备了光致抗蚀剂,测试了抗蚀剂的耐酸性及分辨率。研究结果表明:随着共聚物中N-PMI含量的增加,共聚物的分子量和玻璃化转变温度(Tg)升高;制备的光致抗蚀剂耐酸性良好,共聚物P3对应光致抗蚀剂的分辨率达40 μm。
| [1] | Huang H Y,Chen H. Preparation and photo- and thermal-curing properties of copolymers applied in negative-type photoresists[J]. Molecular Crystals and Liquid Crystals,2011,548(1):3-16. |
| [2] | Liu J C,Lin L C,Jia X L,Liu R,Zhang S W,Liu X Y. Synthesis and properties of UV-curable hyperbranched polyurethane and its application in the negative-type photoresist[J]. Journal of Wuhan University of Technology-Mater,2014,29(1):208-212. |
| [3] | Chang S,Yang J H,Chien J H,Lee Y D. Synthesis of a novel alkaline-developable photosensitive copolymer based on MMA, MAA, SM, and 2-HEMA-grafted GMA copolymer for an innovative photo-imageable dry-peelable temporary protective plastisol[J]. Journal of Polymer Research,2013,20(4):1-11. |
| [4] | 许 箭,陈 力,田凯军,胡 睿,李沙瑜,王双青,杨国强. 先进光刻胶材料的研究进展[J]. 影像科学与光化学,2011,29(6):417-429. Xu J,Chen L,Tian K J,Hu R,Li S Y,Wang S Q,Yang G Q. Molecular structure of advance photoresists[J]. Imaging Science and Photochemistry,2011,29(6):417-429. |
| [5] | 刘建国,蒋 明,曾晓雁. 一种248 nm光刻胶成膜树脂的合成及相关性能研究[J].影像科学与光化学,2013,31(5):349-360. Liu J G, Jiang M,Zeng X Y. Research on the synthesis and properties of a matrix resin to be used for 248 nm photoresist[J]. Imaging Science and Photochemistry,2013,31(5):349-360. |
| [6] | 郑金红. I-Line光刻胶材料的研究进展[J]. 影像科学与光化学,2012,30(2):81-90. Zheng J H. Evolution and progress of I-line photoresist materials[J]. Imaging Science and Photochemistry,2012,30(2):81-90. |
| [7] | Liu J G,Nakamura Y,Ogura T,Shibasaki Y,Ando S,Ueda M. Optically transparent sulfur-containing polyimide-TiO2 nanocomposite films with high refractive index and negative pattern formation from poly(amic acid)-TiO2 nanocomposite film[J]. Chemistry Materials,2008,20(1):273-281. |
| [8] | Lin H M,Hseihc K H,Chang F C. Characterization of negative-type photoresists containing polyhedral oligomeric silsesquioxane methacrylate[J]. Microelectronic Engineering,2008,85(7):1624-1628. |
| [9] | Lee C K,Don T M,Lai W C,Chen C C,Lin D J,Cheng L P. Preparation and properties of nano-silica modified negative acrylate photoresist[J]. Thin Solid Films,2008,516(23):8399-8407. |
| [10] | Cheng T S,Wu M H,Weng W S,Chen H. Synthetic study and material applications for a positive photoresist of the acrylic series[J]. Materials Letters,2002,57(3):753-760. |
| [11] | Nozaki K. Material innovations for 193 nm resist[J]. Journal of Photopolymer Science and Technology,2010,23(6):795-801. |
| [12] | 谢 文,刘建国,李 平.一种新型紫外正型光刻胶成膜树脂的制备及光刻胶性能研究[J]. 影像科学与光化学,2010,28(1):52-58. Xie W,Liu J G,Li P. A novel UV photoresist matrix resin and its photolithographic processes[J]. Imaging Science and Photochemistry,2010,28(1):52-58. |
| [13] | 刘建国. 两种耐高温紫外正型光刻胶成膜树脂的制备及性能[J]. 影像科学与光化学,2012,30(5):330-337. Liu J G. Preparation and properties of two high-thermostability matrix resins for UV positive photoresist[J]. Imaging Science and Photochemistry,2012,30(5):330-337. |
| [14] | Sakii D,Takahashi A,Oyama T. Development of photosensitive vinyl polymers with imide group based on reaction development patterning[J]. Journal of Photopolymer Science and Technology,2012,25(3):371-374. |
| [15] | Liu J G,Li P,Liu H P,Zhang J S. A novel amide-imide copolymer as a matrix resin for ultraviolet photoresists: preparation, properties, and application[J]. Journal of Applied Polymer Science,2010,117(6):3715-3721. |
| [16] | 胡孝东,罗时剑,颜德岳.甲基丙烯酸甲酯-苯乙烯-N-苯基马来酰亚胺三元共聚物的研究[J].高分子学报,1992, 6:696-700. Hu X D, Luo S J, Yan D Y. Investigation on methacrylate-styrene-N-phenylmaleimide terpolymer[J]. Acta Polymerica Sinica, 1992, 6: 696-700. |




