纳机电系统(NMES)是微机电系统(MEMS)向小型化、高集成、低功耗方向进一步发展而拓展出的研究领域。纳米尺度的谐振器是NEMS的重要组成部分,特别是纳米线谐振子是多种NEMS谐振器的核心结构。在纳米尺寸下器件表现出强烈的尺度效应,具有超高频率,能够达到MHz甚至GHz。例如,加州理工大学制备的SiC双端固支梁谐振频率高达134 MHz[1]。与普通MEMS谐振器相比,此类超薄纳米梁谐振子频率更高、功耗更低、灵敏度和品质因数更高[2],常应用于高精度传感器、高频混频器[3]等。
目前,一维纳米线材料制备方法多种多样[4]。其制备方法可分为自下而上法和自上而下两种方法。其中,自下向上法是应用一系列方法使原子、分子等生长为纳米结构(例如热蒸发、液相沉积等),常用的自下向上法包括气-液-固法(VLS)[5,6]、溶液固法(SLS)[7,8]、模板合成法[9]。自上而下法是利用刻蚀等方法将大尺寸体材料加工到所需的纳米结构,常用的自上而下法包括光刻法[10] 、金属辅助化学腐蚀法[11]等。但是目前制备一维纳米线结构需要解决的问题还有很多,比如:如何在大规模制备纳米线材料时精确控制三维尺寸以及形貌;如何将一维纳米线组装成元器件等。对于 NMES纳米线谐振子,由于其特征尺寸小,要制备稳定、重复的纳米结构,对加工技术要求很高。首先,使用自下而上法制备的纳米线难于集成,且尺寸大小不能精确控制,而自上而下法中的光刻法步骤简单,线宽尺寸和位置可控,可用于大规模的纳米器件制备。其次,纳米梁对应力非常敏感,多采用单晶材料制作。而单晶硅具有良好的晶体结构,机械性能高,微细加工技术成熟,与CMOS工艺兼容,是MEMS最基本最常用的材料,也是纳米谐振子制备的理想材料之一。
近年来出现了不少通过MEMS 技术实现硅纳米结构加工的方法。例如,Toriyama T等[12]选用注氧硅衬底 (SIMOX),用电子束光刻(EBL)定义纳米线,反应离子刻蚀(RIE)并湿法腐蚀掉二氧化硅牺牲层,最终得到长3 μm、厚53 nm、宽100 nm的纳米梁。Koumela A等[13]用类似的方法制备了直径约40 nm的硅纳米梁。通过使用绝缘上硅衬底(SOI),Za′bah N F等[14]结合氧化和KOH对硅的各向异性腐蚀,制备了直径约50 nm的硅纳米线。但是这些方法需要以SOI衬底为加工材料,价格较为昂贵(1片SOI衬底的成本约相当于30片单晶硅片)。基于体硅制备硅纳米梁的文献也有不少。例如,Tixier-Mita A等[15]利用二次氧化和四甲基氢氧化铵(TMAH)腐蚀硅的方法实现了厚度约为100 nm 的悬臂梁结构的制作。利用二氧化硅对硅侧墙的保护和KOH对硅各向异性腐蚀,Yang H等[16]在(111) 硅片上制作了厚度为47 nm 的双端固支梁结构。然而这些方法工艺复杂,对硅晶面有一定要求。本文研究发展了一种基于浓硼扩散层制备硅纳米线谐振子的方法,该方法采用体硅材料,并合理利用了体硅上浓硼层的湿法腐蚀自停止性质,对硅晶面没有要求,工艺简单,重复性与一致性均较好。经过实验,成功制备了三维尺度可控、特征尺寸约100 nm的硅纳米线谐振子。
1 实验部分基于浓硼扩散层的硅纳米线谐振子制备方法主要包括如下几步:浓硼扩散、电子束光刻、各向异性干法刻蚀以及湿法刻蚀释放纳米线。原材料选用厚度为500 μm双面抛光n型低掺杂(100)硅片,其电阻率为7~13 Ω·cm。工艺流程如图1所示。首先,对硅片进行标准硅片清洗流程,得到干净的样品,如图 1(a)。再采用两步扩散法进行硅片的硼扩散掺杂,以B2O3作为扩散源,进行了温度为1050 ℃、2 min的预扩散。之后,再将硼源取出,进行了温度1175 ℃、3 min的再分布。清洗过后,得到表面薄层浓硼掺杂的硅片,如图 1(b),该层浓硼扩散层可作为之后湿法腐蚀自停止层,也是制备纳米线谐振子的结构层。然后,采用500 nm的ZEP520电子束光刻胶作为掩膜,进行电子束光刻,对二甲苯显影后得到一系列不同纳米尺度的纳米线掩膜图形。之后,通过感应耦合等离子体(ICP)进行各向异性硅刻蚀,其深度大于浓硼层厚度,得到如图 1(c)所示的纳米墙。最后,将ICP刻蚀后的硅片置于TMAH中进行80 ℃、3 min的腐蚀。由于TMAH对轻/重掺杂Si腐蚀速率比高达100[17],腐蚀后将得到释放后悬空的硅纳米线谐振子,如图 1(d)所示。
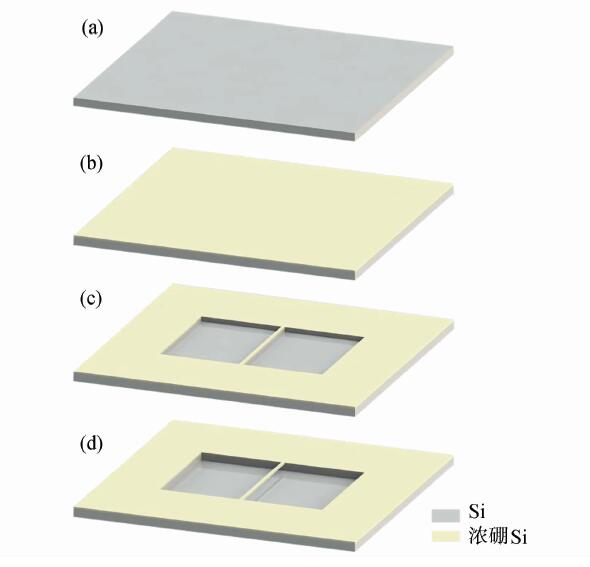 | 图1 基于浓硼扩散层的硅纳米线谐振子制备流程 (a) n型低掺杂硅片;(b) 扩散掺杂硼形成表面浓硼层;(c) 电子束光刻定义纳米线并进行ICP各向异性刻蚀;(d) TMAH溶液腐蚀释放硅纳米线Fabrication process of silicon nanowire resonators based on heavy boron doping layer (a) N type low doped silicon wafer; (b) silicon layer doped by high concentration boron; (c) nanowires defined by Electron beam lithography and ICP anisotropic etching; (d) silicon nanowire resonator released by TMAH solution |
谐振子的频率特性是谐振器件的主要动态特性,而纳米尺度谐振子频率能够达到MHz或GHz量级的谐振频率,具有高力学灵敏度、低功率等特性。采用了双端固支梁的结构,其主要工作模态为弯曲模型,具有较高的谐振频率。这种谐振子的谐振频率能通过以下公式计算:

其中,l和t分别为梁的长度和厚度,E为弹性模量,ρ为材料密度。对于硅材料,C是常数,其值为1.027。
采用COMSOL模拟了如图 2(a)所示的双端固支硅纳米梁,厚度200 nm、宽100 nm、长度5 μm的硅纳米线谐振频率就能够高达68 MHZ,而1μm的同类硅纳米线甚至高达1.7 GHZ,其他长度的纳米线谐振频率最低也在MHz量级,如图 2(b)所示。COMSOL仿真结果与经典公式计算值基本吻合。
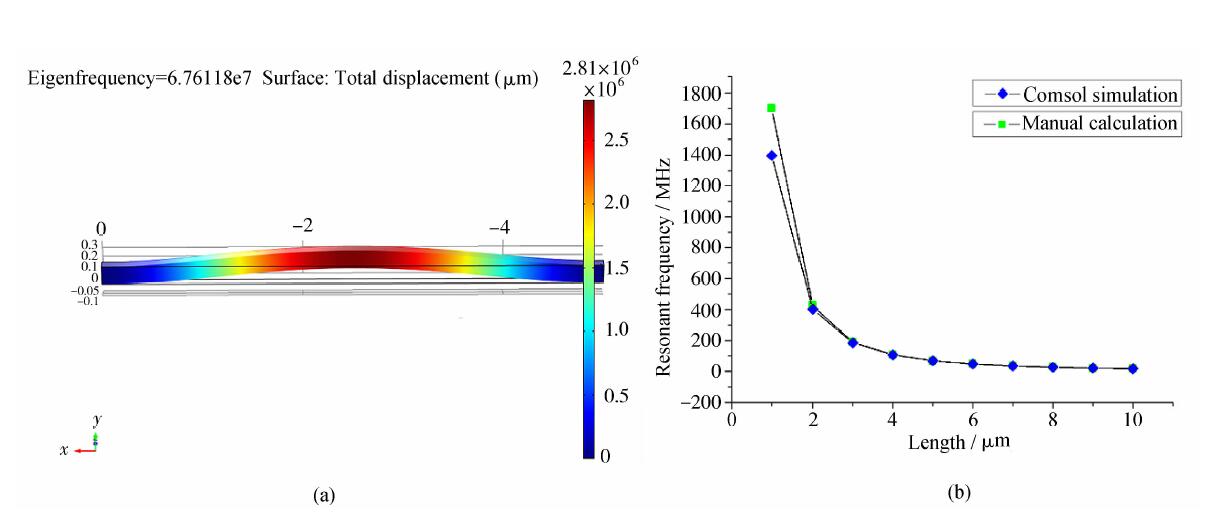 | 图2 (a) 厚度200 nm、宽100 nm、长度5 μm的硅双端固支纳米梁模型;(b) 厚度200 nm、宽100 nm、长度1~10 μm的硅双端固支纳米梁模拟一阶谐振频率 (a) Model of doubly clamped silicon beam resonator with thickness 200 nm,width 100 nm and length 5 μm; (b) the first order resonant frequencies of doubly clamped silicon beam resonators with thickness 200 nm,width 100 nm and length range from 1μm to 10 μm |
为了得到质量较好的浓硼扩散层,采用两步扩散法进行浓硼掺杂。通过该方法控制温度、时间等工艺条件,可以得到均匀平坦的界面,其重复性、均匀性较好。以B2O3作为扩散源,在不同温度和不同时间下进行了一系列扩散掺杂实验。预扩散与再分布两个阶段均在扩散炉的恒温区中进行,整个过程通入氮气起到保护作用,维持炉管正压,防止外界气体污染。
为了测量不同掺杂浓度的硼硅层的厚度,利用TMAH腐蚀掺杂硼Si的自停止特性,即TMAH溶液对掺杂硼浓度超过4×1019 cm-3的Si片腐蚀速率陡然下降[17, 18],将样品放入TMAH溶液中进行90 ℃、30 min的腐蚀,暴露出扩散后的浓掺杂硼硅层,如图 3(a)所示。SEM观察后发现,进行温度为1050 ℃、2 min预扩散和温度1175 ℃、3 min再分布的硅片,其掺杂硼硅层厚度约700 nm。
为了得到浓硼层掺杂浓度,用四探针法测量了浓硼扩散后Si片表面方块电阻,平均为4.7Ω/□,其掺杂浓度接近1×1020 cm-3量级,满足了自停止腐蚀层的要求。同时在之后的实验中,发现TMAH对浓硼硅层几乎没有腐蚀作用,在放大16万倍的情况下,其表面仍然平坦均匀,没有出现明显的凹凸现象,见图 3(b)。
 | 图3 (a)TMAH腐蚀后暴露出扩散后的浓掺杂硼硅层,测量浓硼扩散层约为700nm;(b)经过TMAH腐蚀后的形貌,放大16万倍情况下,表面仍然平坦均匀 (a) Silicon layer doped with high concentration boron etched by TMAH solution which is about 700 nm in thickness; (b) uniform morphology and smooth surface after TMAH etching enlarged by 160 thousand times |
为得到宽度100nm尺度的纳米线,采用电子束光刻ZEP520电子束光刻胶来获得ICP刻蚀掩膜。电子束光刻精度高,加工尺寸可达百纳米甚至十纳米数量级,而ZEP520电子束光刻胶分辨率高,侧壁垂直,抗刻蚀性能好。但是,要得到形貌较好的纳米线,需要进行一系列的测试。首先在扩散后的Si片上旋涂500 nm的光刻胶,180 ℃烘烤3 min,并用电子束光刻机进行了不同剂量、不同线宽的测试。曝光图形为两边矩形,而中间未曝光部分则是纳米线掩膜。图 4(a)是显影后得到的掩膜SEM图,中间纳米线线宽80nm,如图 4(b),其形状规则,边缘光滑,适合用于ICP刻蚀纳米线。
得到纳米线的掩膜后,使用ICP刻蚀Si,暴露出下层低掺杂n型硅,其深度大于700 nm,实际深度约1.6 μm。然而,当使用中间线宽为100 nm左右的版图时,发现纳米墙被刻穿的现象,探寻其中原因是:(1) 电子束光刻时,采用过曝光以满足各个部分均被曝光,得到的掩膜胶纳米线实际尺寸要小于版图中的纳米线;(2)ICP刻蚀过程中,胶边首先被消耗,导致纳米线变窄,另外,出现部分横向刻蚀。这些原因导致实际纳米线线宽与版图不一致,甚至部分版图设计过窄导致纳米墙被刻穿。经过调整,采用300 nm线宽的版图电子束曝光后并进行ICP刻蚀,得到了纳米墙结构,如图 4(c)所示。其形貌规则,界面光滑平整,取得了良好的效果,如图 4(d)所示。
同时,在大量测试的结果下,得到了如图 5所示的纳米线线宽变化图。其变化呈现出一定的规 律:ICP刻蚀后纳米结构线宽比版图上的线宽减少200 nm。这为进行大面积可控制备纳米线积累了基础工艺数据。
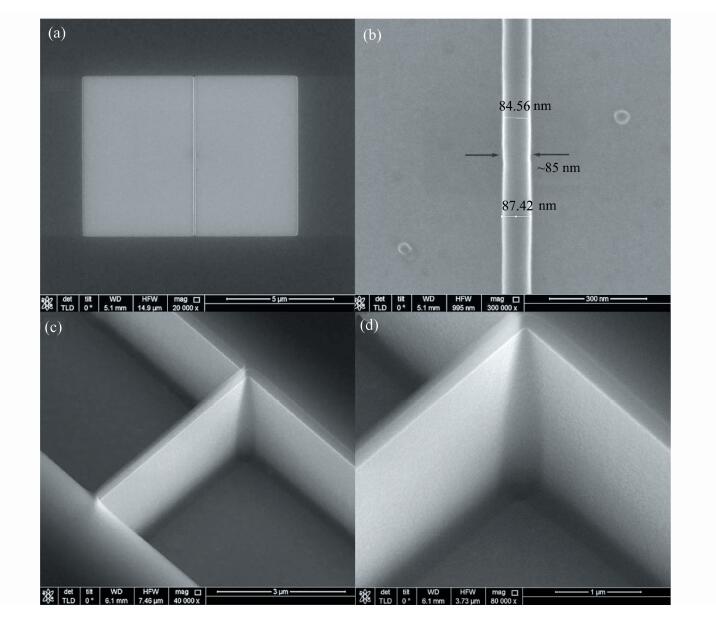 | 图4 (a) 电子束光刻后的掩膜版;(b) 胶纳米线宽80 nm;(c) ICP刻蚀后得到的纳米墙;(d) 纳米墙局部细节SEM图 (a) Mask image after the electron beam lithography; (b) photoresist nanowire with width about 80 nm; (c) nano wall obtained by ICP etching; (d) SEM image of the local details of the nano wall |
 | 图5 (版图设计纳米线线宽与实际得到线宽对比 The width designed VS the width obtained |
为了释放纳米线,得到悬空的硅纳米线谐振子,采用TMAH溶液对刻蚀后的图形进行腐蚀,通过腐蚀衬底硅实现梁的释放,降低了释放的操作难度。根据已有文献,质量分数25%的TMAH溶液在80 ℃时对低掺杂浓度的Si(100)腐蚀速率约为1 μm/min[19],而对浓度超过4×1019 cm-3的掺硼Si腐蚀速率陡然下降。对于掺杂浓度接近1×1020 cm-3量级的浓硼硅层,其腐蚀速率在(100)面低至10 nm/min[17],低/高浓度掺杂硅腐蚀选择比高达100。按照此理论计算,对于宽100 nm的纳米墙,其下暴露出的低掺杂硅仅仅6 s就会被腐蚀穿。为了保证腐蚀后纳米线均被完全释放,将样片在TMAH溶液中80 ℃腐蚀3 min,释放得到的纳米线如图 6所示。图 6(a)是1 μm纳米墙释放的结果,悬空梁高约700 nm,宽约90 nm,形貌规则;而图 6(b)和图 6(c)中的纳米梁长度分别为2 μm和5 μm,其尺度可控。图 6(d)是10 μm的多条纳米梁同时释放结果,其中每条纳米梁腐蚀程度一致,厚度、宽度几乎相同。由图可见,在该方法中,通过ICP刻蚀可以得到表面平滑的纳米线,而在TMAH腐蚀衬底释放纳米线的同时,又保持了浓硼层纳米线的表面形貌,得到的硅纳米线谐振子形貌规则,尺度可控,一致性较好,结构可靠。
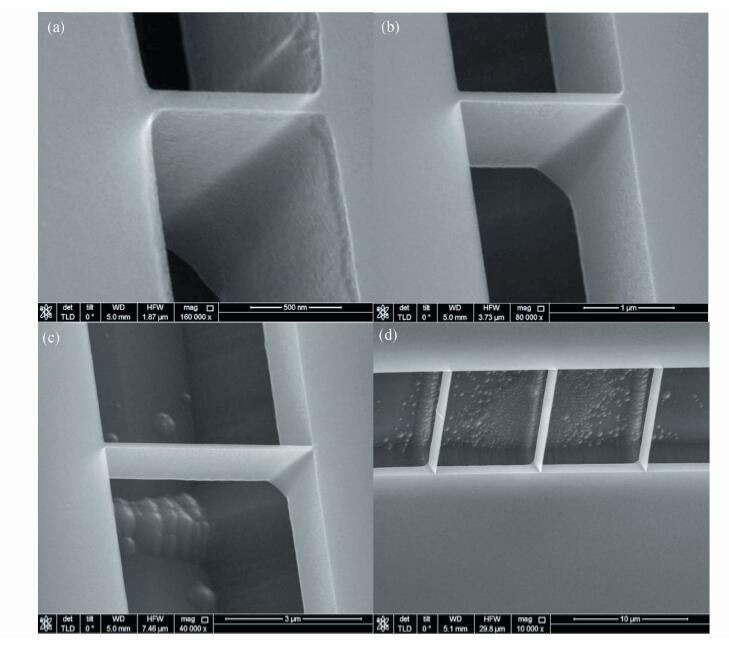 | 图6 释放后的纳米线SEM图 (a) 释放后长1 μm、厚700 nm、宽90 nm的纳米梁;(b) 长2 μm的纳米梁;(c) 长5 μm的纳米梁;(d) 长10 μm多条纳米梁同时释放结果SEM images of the nanowires released (a) Silicon beam resonator with thickness 700 nm,width 90 nm and length 1 μm; (b) silicon beam resonator with length 2 μm; (c) silicon beam resonator with length 5 μm; (d) multiple silicon beam resonators with length 10 μm by simultaneously releasing |
本文研究了基于浓硼扩散层的硅纳米线谐振子制备方法。对硅纳米线谐振频率进行了模拟研究,其频率高达MHz以上。并探索了两步扩散法实现浓硼扩散层低厚度、高扩散浓度的工艺条件。通过电子束光刻以及ICP刻蚀得到了规则的约100 nm线宽的纳米墙。最后基于浓硼扩散硅层的自停止效应,在体硅上得到了悬空纳米线谐振子。此方法可实现可控制的大面积、高产率、高可靠度、低成本的硅纳米线谐振子制备,为今后的实验提供了可行性参考。
| [1] | Yang Y T, Ekinci K L, Huang X M H, Schiavone L M, Roukes M L, Zorman C A, Mehregany M. Monocrystalline silicon carbide nanoelectromechanical systems[J]. Applied Physics Letters, 2001, 78: 162-164. |
| [2] | Craighead H G. Nanoelectromechanical systems[J]. Science, 2000, 290: 1532-1536. |
| [3] | Erbe A, Blick R H. Silicon-on-insulator based nanoresonators for mechanical mixing at radio frequencies[J]. IEEE Transactions on Ultrasonics Ferroelectrics & Frequency Control, 2002, 49: 1114-1117. |
| [4] | 李永军, 刘春艳. 一维无机纳米材料的研究进展[J]. 感光科学与光化学, 2003, 21(6): 446-468. Li Y J, Liu C Y. Research progress of one-dimensional inorganic nanomaterials[J]. Photographic Science and Photochemistry, 2003, 21(6): 446-468. |
| [5] | And Y W, Yang P. Germanium nanowire growth via simple vapor transport[J]. Chemistry of Materials, 2015, 31(22): 605-607. |
| [6] | Johnson D C, Mosby J M, Riha S C, Prieto A L. Synthesis of copper silicide nanocrystallites embedded in silicon nanowires for enhanced transport properties[J]. Journal of Materials Chemistry, 2010, 20: 1993-1998. |
| [7] | Holmes J D, Johnston K P, Doty R C, Korgel B A. Control of thickness and orientation of solution-grown silicon nanowires[J]. Science, 2000, 287: 1471-1473. |
| [8] | Wang F D, Dong A G, Sun J W, Tang R, Yu H, Buhro W E. Solution-liquid-solid growth of semiconductor nanowires[J]. Inorganic Chemistry, 2006, 45: 7511-7521. |
| [9] | Cao G Z, Liu D W. Template-based synthesis of nanorod, nanowire, and nanotube arrays[J]. Advances in Colloid and Interface Science, 2008, 136: 45-64. |
| [10] | Jang M, Park Y, Hyun Y, Jun M, Choi S J, Zyung T, Kim J D. Top-down processed silicon nanowires for thermoelectric applications[J]. Journal of Nanoscience and Nanotechnology, 2012, 12: 3552-3554. |
| [11] | Qi Y Y, Wang Z, Zhang M L, Yang F H, Wang X D. A processing window for fabricating heavily doped silicon nanowires by metal-assisted chemical etching[J]. Journal of Physical Chemistry C, 2013, 117: 25090-25096. |
| [12] | Toriyama T, Sugiyama S. Single crystal silicon piezoresistive nano-wire bridge[J]. Sensors and Actuators A-Physical, 2003, 108: 244-249. |
| [13] | Koumela A, Mercier D, Dupre C, Jourdan G, Marcoux C, Ollier E, Purcell S T, Duraffourg L. Piezoresistance of top-down suspended Si nanowires[J]. Nanotechnology, 2011, 22: 653-658. |
| [14] | Za'bah N F, Kwa K S K, Bowen L, Mendis B, O'Neill A. Top-down fabrication of single crystal silicon nanowire using optical lithography[J]. Journal of Applied Physics, 2012, 112: 024309 - 024309-5. |
| [15] | Tixier-Mita A, Mita Y, Fujita H. A simple, robust and controllable nano-structures fabrication technique using standard silicon wafers. In: Hocker G B, Howe R T, et al., eds. TRANSDUCERS 2003-The 12th International Conference on Solid-State Sensors, Actuators and Microsystems. Boston: IEEE, 2003. 250-253. |
| [16] | Yang H, Xu K F, Yang Y L, Li T, Jiao J W, Li X X, Wang Y L. A novel method to fabricate single crystal nano beams with (111)-oriented Si micromachining[J]. Microsystem Technologies, 2008, 14: 1185-1191. |
| [17] | Steinsland E, Nese M, Hanneborg A, Bernstein R W, Sandmo H, Kittilsland G. Boron etch-stop in TMAH solutions[J]. Sensors and Actuators A-Physical, 1996, 54: 728-732. |
| [18] | 李国正. Si的化学自停止腐蚀方法的研究[J].微电子学, 1995, 4: 45-47. Li G Z. Techniques for chemical self-etch-stop etching of silicon[J]. Microelectronics, 1995, 4: 45-47. |
| [19] | Thong J T L, Choi W K, Chong C W. TMAH etching of silicon and the interaction of etching parameters[J]. Sensors & Actuators A-Physical, 1997, 63: 243-249. |




