在全球网络化、信息化发展蒸蒸日上的今天,微电子工业得到蓬勃发展,而微电子工业的发展依赖于光刻技术(photolithography)的进步。集成电路加工是通过光刻实现的,所需的关键材料就是光致抗蚀剂(photoresist)。光致抗蚀剂又称光刻胶,是一种经过曝光后能发生光化学反应,引起曝光区溶解性能的变化,通过显影实现精细图形转移的材料。光刻技术是指利用光刻胶的曝光、显影、刻蚀、去胶等过程,实现将精细图形从掩膜板(mask)转移至基材上的技术[1]。
光刻胶分为正胶和负胶:曝光后选择适当的显影液将曝光区显影除去,未曝光区保留下来,形成与掩膜板一致的图像为正胶;而未曝光区被显影除去,形成与掩膜板相反的图像,则为负胶。评价光刻胶性能的主要参数包括分辨率(resolution)、灵敏度(sensitivity)、耐蚀刻性(etch resistance)、线边缘粗糙度(line edge roughness)、储存稳定性(storage stability)等。
传统光致抗蚀剂主要由成膜树脂、光敏剂、溶剂及其它添加剂组成,其在曝光下发生的光化学反应是化学计量的,即每吸收一个光子至多引起一次光化学反应。传统光致抗蚀剂类型包括聚乙烯醇-肉桂酸酯负性光刻胶、环化橡胶-双叠氮负性光刻胶、重氮萘醌-线性酚醛树脂正性光刻胶。80年代初,IBM公司的Ito等提出了化学增幅型光致抗蚀剂(chemically amplified photoresist),其在曝光时可以产生强酸作为催化剂,可在后烘过程中催化光刻胶膜层发生化学反应,但催化剂不会被消耗,提高了反应效率,从而大大提升了光刻胶的感度和分辨率[2-5]。分辨率是光刻技术中最重要的性能指标,图形的分辨率越高所制作集成电路的集成程度也就越高,而图形分辨率与其曝光波长成反比,因此缩小光刻技术的曝光波长是提高图形分辨率的主要途径。光刻技术按照所用曝光光源波长的不同,经历了几个阶段:g线(436 nm)、i线(365 nm)、KrF激光(248 nm)、ArF激光(193 nm),以及近几年开始进入实用阶段的EUV(13~14 nm)光刻[6]。
随着曝光光源波长不断缩小,对光刻胶材料的性能提出了更高的要求。耐蚀刻性和透明性是评价光刻胶材料性能好坏的重要指标。通常可以采用对聚合物进行部分氟化的方法来提高其在紫外区的透明性,但由氟化聚合物制备的光刻胶在成像性能方面并没有得到提升[7]。聚合物的耐蚀刻性能与其碳氢比密切相关,聚合物所含C—C键越多,耐蚀刻性就越高。另外,含有无机元素也可以起到同样的效果。这两种方法都被用于设计增强光刻胶的耐蚀刻性。
多面体低聚倍半硅氧烷(polyhedral oligosilsesquioxane,POSS)结构如图 1所示,它由无机硅氧笼型结构和外层的有机基团R构成,R为提高相容性与增溶作用的有机基团,X为含有一个或多个可参与聚合反应的活性基团。有机-无机杂化结构使得POSS的热力学和化学性质都得到增强,具有良好的热稳定性、较高的玻璃化转变温度、良好的空间稳定性和机械性能,易于功能化修饰[8-11]。将其作为核,引入体积较大的侧基后,可用于制备光刻胶材料。含有POSS基团的光刻胶材料抗蚀刻性非常强。

|
图 1 多面体低聚倍半硅氧烷的结构 The structure of POSS |
Jakúbek等[12]探究了几种可以增加聚合物在157 nm处的透明性和耐蚀刻性的方法,发现在甲基丙烯酸金刚烷酯聚合物中引入适量POSS可以明显提高透明性和耐蚀刻性。Eon等[13]从实验和理论上研究了POSS材料在氧等离子体蚀刻(oxygen plasma etching)中的化学和结构变化,发现在等离子体中,POSS材料表面会形成氧化硅保护层,阻止了等离子体对基材的腐蚀和消耗。另外,POSS基团在193 nm和157 nm处均有良好的透明性,因此含有POSS基团的光刻胶材料得到越来越广泛的关注。按照POSS的活性基团X的种类不同,目前研究较多的含POSS的光刻胶主要包括环氧-POSS(epoxy-POSS)光刻胶、甲基丙烯酸酯-POSS(methacrylate-POSS)光刻胶和重氮酮-POSS(diazoketo-POSS)光刻胶,本文将作逐一介绍。
1 含POSS光刻胶的主要类型 1.1 环氧-POSS光刻胶Li等[14]将环氧环己基接入到POSS上(如图 2所示),制备了一种负性光刻胶,加入光产酸剂(photoacid generator,PAG),利用干涉光刻技术,经两束波长为532 nm的干涉光曝光后,环氧基团受酸催化后发生交联反应,经后烘、显影等过程,获得了分辨率为300 nm、深宽比为10的图形,具体过程如图 3所示。

|
图 2 环氧环己基POSS结构 The structure of epoxy-POSS |
1.2 甲基丙烯酸酯-POSS光刻胶
甲基丙烯酸酯类聚合物因其良好的透明性,常被用作193 nm光刻胶材料,而POSS基团在193 nm处没有吸收,因此研究者将POSS基团接入到甲基丙烯酸酯的共聚物中,以提高光刻胶的耐蚀刻性。
Wu等[15]设计合成了一种用于193 nm光刻的甲基丙烯酸酯共聚物光刻胶材料。研究发现,将质量分数为20%的POSS基团接入到聚合物链上,可以明显增强聚合物的抗等离子蚀刻性能,这归因于POSS晶体的笼形网络结构在聚合物中的均匀分布,且其在193 nm有较高的透明性,所得图形的分辨率高。
Tegou等[7]将POSS引入到甲基丙烯酸酯单体上,再与其它单体进行共聚(如图 4所示),用作化学增幅型正性光刻胶,经157 nm光源曝光后,聚合物发生酸催化的脱保护过程,由碱水不可溶变为碱水可溶,所得图形分辨率可达到100 nm,通过优化单体组成可获得较好的成膜性、高的感度及良好的抗蚀刻性能,具有潜在的成为双层抗蚀剂的价值。
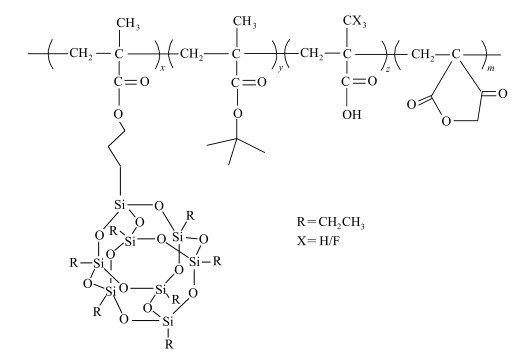
|
图 4 含POSS甲基丙烯酸酯类共聚物结构 The structure of methacrylate-POSS |
另外,POSS基团还可以增强光刻胶的感度,这是因为在温和的焙烧条件下,光刻胶中的POSS结构有利于脱保护后的—COOH相互靠近,促进分子内和分子间酸酐的形成,从而提高反应效率。而连有乙基的POSS基团与连有环戊基的POSS基团相比,有更强的抗蚀刻性和较低的表面粗糙度,因而有利于减小光刻胶膜层的表面粗糙度,得到高分辨率的成像图形。
小分子光产酸剂与成膜树脂在尺寸上固有的不兼容性会导致产酸剂的相分离,且存在光照后产酸分布不均一及后烘过程中出现酸扩散现象等问题,导致膜层中脱保护反应的反应程度不一致,从而直接影响了最终图形的分辨率和线边缘粗糙度[16-19]。另外,化学增幅型光刻胶在曝光后要立即后烘,不能长时间暴露于空气中,否则空气中的碱性物质易中和膜层表面的酸,使得靠近膜层表面的光刻胶分解不彻底而在显影液中溶解性下降,形成“T”型图形[20]。基于此,Ali等[21]将光产酸剂和POSS基团直接接枝到聚合物链上,设计合成了一种应用于电子束光刻技术的新型纳米复合材料,结构如图 5所示。研究发现,这种方法不仅增加了光产酸剂在有机溶剂中的溶解度,提高了在光刻胶中的含量,进而提高了感度,而且解决了小分子光产酸剂存在的相分离、酸扩散不均匀及后烘过程中的酸迁移问题,提高了光化学反应的效率。而POSS基团的接入增强了光刻胶材料的耐蚀刻性,且随着POSS基团在聚合物中含量的增加,耐蚀刻性得到相应的增强。该光刻胶用于高压电子束光刻和低压电子束光刻均能得到较好的图形。

|
图 5 纳米复合光刻胶结构 The structure of nanocomposite resist |
上述文献引入POSS基团的方式都是通过将其接枝到聚合物链上,除此之外,POSS基团的引入还可以采用与其它聚合物进行物理混合的方式。Lin等[22]通过混合不等量的甲基丙烯酸酯-POSS与其它聚合物,制备了非化学增幅型负性光刻胶。这些POSS大分子在基质中有结晶和聚集倾向,聚合物中的羟基和POSS硅氧烷的氢键作用诱导了聚合物在POSS周围的双结合(如图 6所示),从而增加了光照聚合速度和感度,随加入POSS基团含量的增大,其感度也相应增加。含有2.9%(质量分数)MI-POSS的共聚物体系经紫外曝光、显影后,可获得分辨率为50 μm、高度为25 μm的图形。

|
图 6 基于氢键作用的MI-POSS光敏共聚物微观结构设想[22] The proposed microstructure via hydrogen bonding interaction between a MI-POSS particle photosensitive copolymers[22] |
化学增幅型光刻胶利用酸催化分解或交联反应来改变光刻胶曝光前后的溶解性,达到显影成像的目的。由于其具有较高的光化学反应效率,已被广泛地应用于集成电路的加工方面。但化学增幅型光刻胶除了存在酸扩散不均匀、酸迁移等问题外,还会对一些基材造成腐蚀。Kim等[23]仔细分析了化学增幅型光致抗蚀剂存在的问题,并发展了一种非化学增幅型的正性光刻胶——重氮酮官能化的POSS。他们将POSS插入到重氮酮化合物中以增强光刻胶的热稳定性和力学性能,通过重氮酮官能团在紫外灯照射下发生Wolff重排,生成一个羧基基团,从而改变了溶解度。合成路线如图 7所示。CDEOPE-POSS经深紫外光曝光后,无需后烘,就可以获得分辨率为0.7 μm的图形。

|
图 7 CDEOPE-POSS的合成过程 Overall synthetic procedure of CDEOPE-POSS |
Woo等[24]也将POSS应用到了非化学增幅型的负性光致抗蚀剂的研究中,他们将重氮酮和含羟基的单体与POSS共聚,重氮酮作为感光部分经紫外光照射发生Wolff重排,生成烯酮,再与羟基发生加成反应生成一个交联的网状结构(如图 8所示),从而溶解度发生改变。PDHPS和SU-8光刻胶结合作为双层抗蚀剂使用,经深紫外光光刻和氧等离子体蚀刻,得到了分辨率分别为2 μm、400 nm、200 nm的负性图形。

|
图 8 DOBEMA和HEMA在PDHPS中的紫外交联机理 The UV induced crosslinking mechanism of DOBEMA and HEMA in PDHPS |
POSS具有稳定的纳米笼形结构,可广泛用作光致抗蚀剂的增强材料。含有POSS结构的光刻胶具有良好的热稳定性、空间和结构稳定性及突出的抗等离子蚀刻性能等优点,因此,POSS改性的聚合物材料在光刻胶领域中具有很好的应用前景。但对含POSS光刻胶还需作深入的研究。一方面,由于POSS单体合成周期长、产率低、成本高,难以实现工业化生产,一直制约着POSS材料的发展,因此要努力寻找POSS单体新的合成路径,设计合理的合成路线,提高POSS的收率,降低成本,缩短周期,为POSS改性光刻胶材料的发展奠定基础;另一方面,要深入开展POSS作为光刻胶增强材料的理论研究,明确POSS对光刻胶的作用机理,努力将含POSS光刻胶付诸实际应用和生产,推动微电子加工产业的发展。
| [1] |
Wallraff G M, Hinsberg W D. Lithographic imaging techniques for formation of nanoscopic features[J]. Chemical Review, 1999, 99(7): 1801-1822. DOI:10.1021/cr980003i |
| [2] |
Ito H. Chemical amplification resists: inception, implementation in device manufacture and new developments[J]. Journal of Polymer Science Part A-polymer Chemistry, 2003, 41(24): 3863-3870. DOI:10.1002/pola.10963 |
| [3] |
Ito H. Chemical amplification resists: history and development within IBM[J]. IBM Journal of Research and Deve-lopment, 2000, 44(1/2): 119-130. |
| [4] |
Ito H, Willson C G. Chemical amplification in the design of dry developing resist materials[J]. Polymer Engineering Science, 1983, 23(18): 1012-1018. DOI:10.1002/pen.760231807 |
| [5] |
Ito H. Chemically amplified resist: past, present and future[C]. In: Conley W. Proceedings of the Society of Photo-optical Insrrumentation and Engineers(SPIE). USA: SPIE-INT SOC Optical Engineering, 1999. 2-12. https://www.researchgate.net/publication/253209980_Chemically_amplified_resists_Past_present_and_future
|
| [6] |
Ito T, Okazaki S. Pushing the limits of lithography[J]. Nature, 2000, 406(6799): 1027-1031. DOI:10.1038/35023233 |
| [7] |
Tegou E, Bellas V, Gogolides E, Argitis P, Eon D, Cartry G, Cardinaud C. Polyhedral oligomeric silsesquioxane (POSS) based resists: material design challenges and lithographic evaluation at 157nm[J]. Chemistry of Materials, 2004, 16: 2567-2577. DOI:10.1021/cm035089x |
| [8] |
刘玉荣, 黄玉东, 张学忠, 杨小波. POSS改性传统聚合物的研究进展[J]. 宇航材料工艺, 2005, 2: 6-9. Liu Y R, Huang Y D, Zhang X Z, Yang X B. Research progress of the traditional polymer modified by POSS[J]. Aerospace Materials & Technology, 2005, 2: 6-9. |
| [9] |
卢婷利, 梁国正, 宫兆合, 任鹏刚, 张增平. 含倍半硅氧烷的杂化聚合物[J]. 高分子通报, 2004(1): 15-19. Lu T L, Liang G Z, Gong Z H, Ren P G, Zhang Z P. Hybrid polymer containing silsesquioxane[J]. Polymer Bulletion, 2004(1): 15-19. DOI:10.3969/j.issn.1003-3726.2004.01.003 |
| [10] |
肖明艳, 陈建敏. 有机-无机杂化材料的研究进展[J]. 高分子材料科学与工程, 2001, 17(5): 6-10. Xiao M Y, Chen J M. Research progress of organic-inorganic hybrid marerials[J]. Polymer Materials Science & Engineering, 2001, 17(5): 6-10. DOI:10.3321/j.issn:1000-7555.2001.05.002 |
| [11] |
Sellinger A, Laine R M. Silsesquioxanes as synthetic platforms: thermally curable and photo curable inorganic-organic hybrids[J]. Macromolecules, 1996, 29: 2327-2330. DOI:10.1021/ma951499y |
| [12] |
Jakúbek V, Liu X Q, Vohra V R, Douki K, Kwark Y J, Ober C K. Strategies for high transparency acrylate resists for 157 nm lithography[J]. Journal of Photopolymer Science and Technology, 2003, 16(4): 573-590. DOI:10.2494/photopolymer.16.573 |
| [13] |
Eon D, Raballand V, Cartry G, Cardinaud C. Plasma oxidation of polyhedral oligomeric silsesquioxane polymers[J]. Journal of Vacuum Science and Technology B, 2006, 24(6): 2678-2688. DOI:10.1116/1.2382947 |
| [14] |
Li J, Yang S. Fabrication of High-aspect-ratio (up to 10) one-dimensional organic/inorganic hybrid nanogratings via holographic lithography[J]. Microelectronic Engineering, 2014, 128: 7-11. DOI:10.1016/j.mee.2014.06.004 |
| [15] |
Wu H P, Hu Y Q, Gonsalves K E, Yacaman M J. Incorporation of polyhedral oligomericsilsesquioxane in chemically amplified resists to improve their reactive ion Etching resistance[J]. Journal of Vacuum Science and Technology B, 2001, 19(3): 851-856. DOI:10.1116/1.1368672 |
| [16] |
Mendes L A V, Avila L F, Menezes J W, Pinho R R, Lima C R A, Cescato L, Rocco M L M. Photoresists comparative analysis using soft X-ray synchrotron radiation and time-of-flight mass spectrometry[J]. European Polymer Journal, 2009, 45: 3347-3354. DOI:10.1016/j.eurpolymj.2009.10.010 |
| [17] |
Yang D X, Frommhold A, Xue X, Palmer R E, Robinson A P G. Chemically amplified phenolic fullerene electron beam resist[J]. Journal of Materials Chemistry, 2014, 2(8): 1505-1512. |
| [18] |
Givens R S, Kueper L M. Photochemistry of phosphate esters[J]. Chemical Society Reviews, 1993, 93(1): 55-66. DOI:10.1021/cr00017a004 |
| [19] |
Shirai M, Kawaue A, Okamura H, Tsunooka M. Synthesis of novel photo-cross-linkable polymers with redissolution property[J]. Polymer, 2004, 45(22): 7519-7527. DOI:10.1016/j.polymer.2004.09.003 |
| [20] |
Kumada T, Kubota S, Koezuka H. Relationship between patterning and dissolution characteristics of chemical amplification resists using partly protected poly(p-vinylphenol)[J]. Journal of Photopolymer Science and Technology, 1991, 4: 469-472. DOI:10.2494/photopolymer.4.469 |
| [21] |
Ali M A, Gonsalves K E, Agrawal A, Jeyakumar A, Henderson C L. A new nanocomposite resist for low and high voltage electron beam lithography[J]. Microelectronic Engineering, 2003, 70: 19-29. DOI:10.1016/S0167-9317(03)00363-0 |
| [22] |
Lin H M, Hseih K H, Chang F C. Characterization of negative-type photoresists containing polyhedral oligomeric silsesquioxane methacrylate[J]. Microelectronic Enginee-ring, 2008, 85: 1624-1628. DOI:10.1016/j.mee.2008.03.012 |
| [23] |
Kim J B, Ganesan R, Choi J H, Yun H J, Kwon Y G, Kim K S, Oh T H. Photobleachable silicon-containing molecular resist for deep UV lithography[J]. Chemistry of Materials, 2006, 16: 3448-3451. DOI:10.1039/b606937a |
| [24] |
Woo S A, Choi S Y, Kim J B. Non-chemically amplified resists containing polyhedral oligomericsilsesquioxane for a bilayer system[J]. Polymer, 2016, 98: 336-343. DOI:10.1016/j.polymer.2016.06.034 |